PG电子游戏全球封测十大巨头榜单!2018的全球封测领域扩产不停,前十大封测厂积极拉充产能,代工商台积电也积极扩充高端封装产能。
2019年2月,芯思想研究院继推出2017年全球前十大封测公司排名后,再次推出2018年排名。前十大公司名称和去年没有变化。

2018年全球封测总营收达281亿美元,较2017年增长4.3%,前十大封测公司的收入占OSAT营收的80.9%,较2017年增加了1.2个百分点。值得庆贺的是,2018年前十大公司都取得了不同程度的增长。
芯思想研究院在2018年12月发布预估排名就表示,2018年前十大封测公司与2017年相比唯一的变化是,通富微电超越华天科技,由去年的第七上升至全球第六,华天科技则从第六位下滑一位成为第七。其他公司的排名没有变化。

根据总部所在地划分,前十大封测公司中,中国***有五家(日月光ASE、矽品精密SPIL、力成科技PTI、京元电子JYEC、颀邦Chipbond),市占率为42.1%,较去年增长1个百分点;中国有三家(长电科技JCET、通富微电TF、华天科技HUATIAN),市占率为20.7%,较去年增长0.3个百分点;美国一家(安靠Amkor),市占率为15.4%,较去年增长0.1个百分点;新加坡一家(联合科技UTAC),市占率为2.2%,和去年持平。
安靠(Amkor)依托中国上海工厂的快速增长,2018年上海工厂营收整体增幅达到30%,突破50亿元关口,助力安靠全球整体录得3.1%的增长。
长电科技受惠于SiP(系统级封装)、eWLB(嵌入式晶圆级闸球阵列封装)、TSV(硅穿孔封装)、3D封装技术等皆具备世界级实力的先进封装技术,取得2.3%的增长。
通富微电与AMD配套的7nm封测产品已经具备量产实力,在高端市场有较大幅度地增长;苏通工厂则持续聚焦于高端产品,预计整体产能利用率会逐渐提升;合肥工厂的产能利用率逐步提升,也为公司的营收增长提供了支持。2018年通富微电取得11.5%的增长率,在前十大封测公司中,增速排名第二。
受到指纹识别TSV封装和比特币矿机芯片封装订单下滑,CIS封装价格下滑,导致华天科技2018年仅仅有2%的增长,这是华天科技自2007年上市以来录得的最低的增速,2008年和2009年经济危机时,其增幅也有8.9%和4.7%。从2007年上市至今,公司年均增长率达20%。2018年华天科技营收逐季下滑,第四季较第一季下滑20%。
联合科技(UTAC)于2018年初正式关闭上海工厂,产能转移到泰国厂区,整合泰国工厂QFN产能,进一步降低了运营成本。不过在2018年4月传出出售消息,拟10亿美元出售。
颀邦科技(Chipbond)受惠于子公司颀中科技,加大与面板大厂京东方的合作,公司COF产能爆满。
2018年前十大公司合计营收较2017年成长4.3%,相较2017年的成长率10%来说稍显疲态。
2018年前十大封测公司中,营收增幅最大的是力成科技的17.3%,增幅第二是通富微电的11.5%,增幅排名第三的是京元电子的8.6%。
而2017年的增幅前三确实惊人,通富微电、华天科技、长电科技分别以42%、28.04%、24.54%位居营收增幅前三位,而增幅排名第四位的力成科技也高达23.35%。
根据芯思想研究院统计,净利润率排名前三名都来自中国***,分别是颀邦的20.6%、日月光投控(日月光+矽品)的11.4%、力成11.2%。
虽然联合科技(UTAC)的全年净利率超过25%,是由于其第一季净利润高达117%,但扣除其第一季度的营业外收入2.47亿美元后,其第一季度的净利润是负数。其全年的净利润也是负数。所以其年净利润率不具备可比性。
随着集成电路应用多元化,智能手机物联网汽车电子、高性能计算、5G、人工智能等新兴领域对先进封装提出更高要求,封装技术发展迅速,创新特别活跃,竞争特别激烈。先进封装向着系统集成、高速、高频、三维方向发展。当前,高密度TSV技术/Fan-Out扇出技术由于其灵活、高密度、适于系统集成,而成为新时代先进封装的核心技术。
作为封测代工企业(OSAT),面临前道企业在先进封装技术领域的竞争,必须寻求对应低成本高性能封装技术,展开差异化竞争,才能在激烈的竞争中不断发展。
本项目实现100um Ⅲ-Ⅴ族GaAs超薄芯片埋入,所有埋入芯片完好无裂片;在不同Z轴高度埋入10个0201被动元件与2个PA/LNA放大器芯片,形成单一封装体内多层3D系统级埋入的全套工艺能力;三维系统级埋入因没有焊料和引线键合,通过器件表面直接接触薄介质层与金属层实现低热阻的双面散热;封装体表贴开关芯片、数控衰减芯片即可以实现极低Footprint的完整T/R模块。
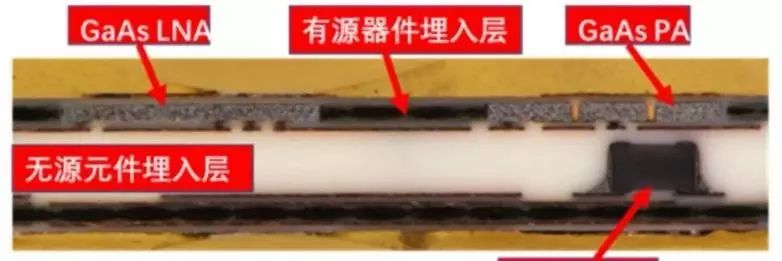
本项目开发异形垫片,实现基于III-V族射频收发模块的三维堆叠;异形垫片可避免破坏芯片表面的空气桥,同时不影响芯片表面微带线的特征阻抗;异形垫片表面与顶层芯片背金键合,通过金线为顶层芯片提供良好接地;样品通过TC、HAST、振动、加速度等航天可靠性测试。
本项目通过TSV转接板实现多颗不同结构或不同功能的芯片系统集成。TSV直径小,间距很密,可以实现高密度芯片封装。芯片与芯片之间的互连通过平面内的线路来实现,可以重新分布电源、接地和信号引脚,这些电学信号可以通过TSV,在底部进行信号输入和输出,从而明显降低输入输出引脚数量。同时,转接板还可以进行散热设计,来进行热管理。
功能芯片无需改变现有的结构和设计,与不同芯片组合搭配,具有很高的灵活度和集成度,适合对尺寸有严苛要求的高频高速的电子产品。同时,所有的芯片和互连线被密封,只有几个端口裸露在外,整个系统有更好的密封性和可靠性
本项目可以用于射频前端等场合,在提高电子系统性能同时大幅缩减系统体积、重量。可通过多层硅转接板的堆叠实现更复杂的系统集成
电子产品的进化依赖于半导体技术的进步,在更紧凑的面积内集成更多功能的器件,IC器件的封装在电子产品系统中扮演着越来越重要的角色。在移动终端中(如手机、平板电脑等)中广泛使用的晶圆级芯片尺寸封装(WLCSP),节约了移动终端的宝贵空间,但是WLCSP芯片裸露在外的本质,很容易在后道组装过程中被损坏。
为避免WLCSP裸片本身的损坏,开发五面塑封保护的WLCSP封装技术,是解决目前WLCSP封装产品缺陷,改善WLCSP Chipping异常,提高芯片良率和可靠性的创新思路。
五面塑封保护WLCSP整体封装厚度≦0.5mm,侧壁塑封体厚度≧10um。满足封装可靠性测试标准:湿气敏感性等级MSL4、温度循环500次、高温存储500小时等。
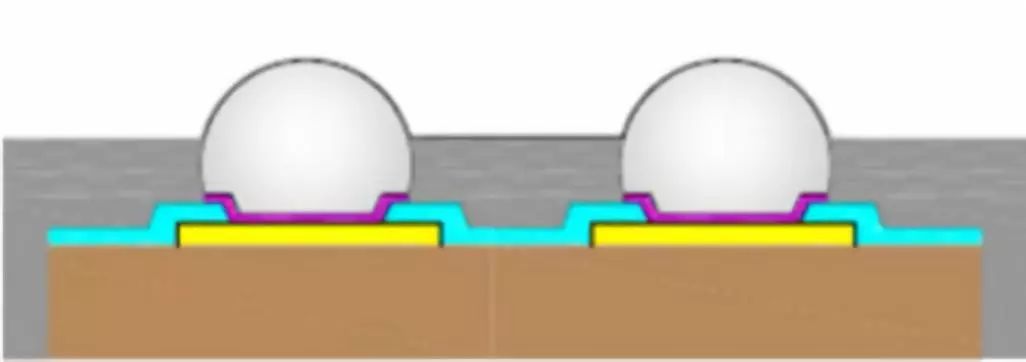
推广五面塑封保护WLCSP封装,有效解决芯片Chipping和Crack异常,拓展WLCSP封装的应用场景。
2018 年长电科技在市场与技术的发展以及系统产品在不同功能要求的情况下,研发了数个封装的新技术,尤其应用在未来即将迅猛发展的5G通讯以及5G下的人工智能(AI)以及物联网 (IoT),期望能够全面跟上局部超越。
双金属板封装结构的制作方法的新技术可形成信号电磁屏蔽、高效功率散热以及高密度线路的扇出等封装技术。而这些效能可以是依据芯片所需功能单独体现也可以融合这些技术综合表现,尤其是应用在 5G 通讯以及物联网(IoT)所需要的信号屏蔽、基地台功率放大要求所产生的功率散热以及讯号高速传输所需要的快速反应与数据计算等,都是非常好且高效的封装技术。

由上图结构图我们可以清楚的看出各项功能所需要搭配的封装结构,而其封装技术中亦包含了芯片正装技术、芯片倒装技术、线路印刷技术、表面贴装技术、金属丝正打以及倒打技术、功率所需要散热装置技术等等,在在都能充分的体现出芯片因系统产品所需要的屏蔽、散热、高密度线路扇岀以及各项的混合功能的封装结构。

而在双金属基板载体的善出封装技术结构中,我们由上图可以明显的看出其中可以融合 PiP 混合封装技术、PiP 芯片各种方式堆栈封装技术、PoP 塑封体与塑封体的堆栈封装等等的技术,在这双金属板载体中充分的发挥出各种封装技术与结构的灵活性以及芯片所需要在系统产品上各项功能的追求。
主要是应用在各类传感以及MEMS的封装技术上。而这种选择性局部塑封技术,可根据需要自行调节选择性地包封封装结构的任一部分,操作简单相对也简化很多繁杂工艺步骤与流程。
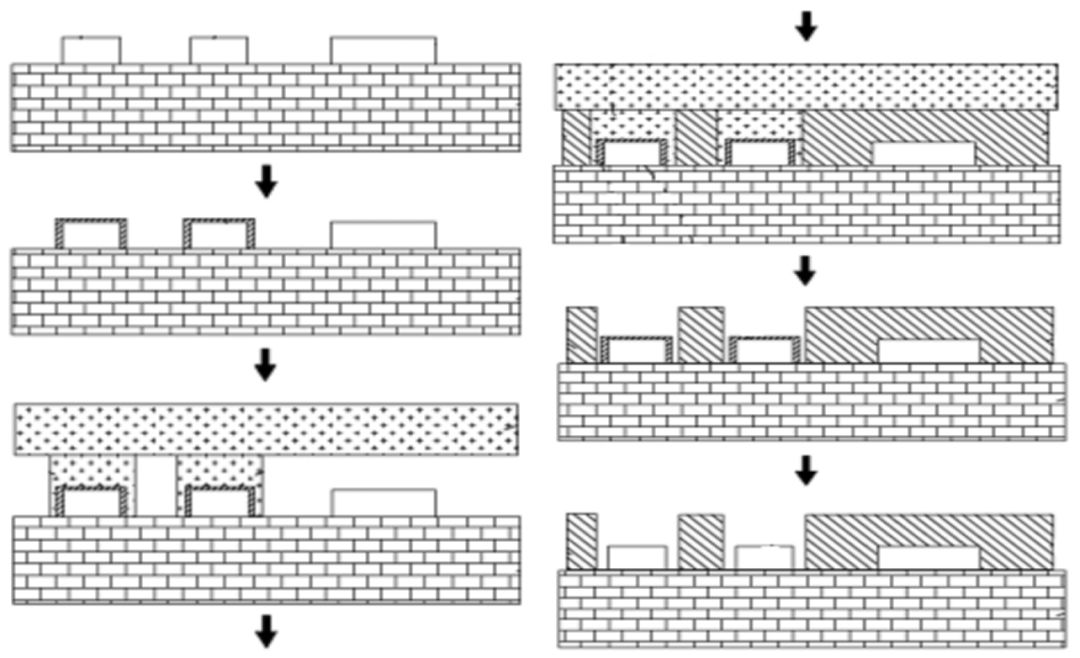
在这种”选择性局部塑封技术”的研发中尚可以轻松体现出电磁屏蔽的功能,以及轻松的体现出”选择性的电磁屏蔽”功能。

封装结构通常包括:基板、基板上方的元器件、用于封装元器件的塑封料、需要包封的元器件以及无需包封的元器件,而通常情况下元器件为功能芯片和无源器件,功能芯片为有源电子元件,需要能量的来源而实现它特定的功能,一般用来信号的放大、转换等。
无源器件是在不需要外加电源的条件下,就可以显示其特性的电子元件,主要是电阻类、电感类和电容类器件,它们的共同特点是在电路中无需加电源即可在有信号时工作,例如:电阻,电容,电感,转换器,渐变器PG电子游戏官方网站,匹配网络谐振器滤波器,混频器和开关等,而采用了”选择性局部塑封”的封装技术将可轻松且灵活的表现出优越的性能。
2018年3月,长电科技子公司江阴长电先进封装有限公司凭借“晶圆凸点及重布线晶圆级封装技术”获得“成果产业化奖”。长电先进研团队通过在圆片级多层重布线封装技术、嵌入式无源器件(IPD)封装技术、高密度铜柱凸块技术等方面的技术创新与突破, 开发了TI、博通联发科海思、Intel、MPS、Onsemi等国际一流客户,成功将项目技术应用于IBM、三星、小米、OPPO、ViVO等国际知名企业的终端产品。创造了项目产品出货量位居中国第一,全球前列的佳绩。
华天科技(昆山)电子有限公司专注于晶圆级封装技术研发与产业化,自2014年以来,通过创新发展,加大投入,开发了Bumping、TSV、WLCSP、WLP-FO等平台技术,并实现了规模化量产。2018年,华天昆山在晶圆级封装领域大踏步前进,取得多个技术和产品突破。
应用于图像传感器的CIS方面,率先完成了12吋BSI产品的验证,率先通过了12吋车载CIS产品验证,解决了一系列技术难题。
2018年华天昆山开发的具有自主知识产权的埋入硅基板扇出型封装技术eSiFO®(embedded Silicon Fan-out)进入量产。该技术使用硅基板为载体,通过在硅基板上刻蚀凹槽,将芯片正面向上放置且固定于凹槽内,芯片表面和硅圆片表面构成了一个扇出面,在这个面上进行多层布线,并制作引出端焊球,最后切割,分离、封装。eSiFO®技术具有如下优点:
由于技术的创新型和巨大应用潜力,2018年3月获评集成电路产业技术创新联盟创新奖。该技术目前有三个主要应用领域,多芯片系统级封装,5G毫米波射频以及三维扇出堆叠。
在5G射频领域,其中多芯片堆叠产品包括4G射频前端,毫米波芯片。2018年11月,华天科技与微远芯发布新闻,成功完成40GHz毫米波eSiFO®封装技术开发,性能优异。
2018年华天昆山进一步开发了基于硅基板的三维扇出技术,值得一体的是埋入硅基板扇出型3D封装结构已获得国家发明专利授权(授权号CN105575913B)。该技术的特点是利用TSV作为垂直互联,互连密度可以大大高于目前的台积电InFO技术。目前工艺已经开发完成,与国际客户进行的产品开发进展顺利。
华天昆山2018年的技术和产品突破,完成了技术转型升级,同时,为后摩尔时代高性能芯片集成封装提供了新的解决方案,随着产品应用的不断丰富,必将推动整个行业的技术发展。
2018年晶方半导充分利用自身拥有知识产权的传感器和高密度封装技术优势,上下游产业链合作伙伴资源,通过针对性解决AI产业发展相关半导体硬件制造难题进行相关先进封装技术研发。
基于以上深厚的微型化传感器制造工艺经验、领先的市场优势与专利布局,完整的大规模量产制造能力,公司已具备实现人工智能应用所需的关键核心技术储备与先发优势,成为自主拥有相关核心制造技术完整开发能力与产业整合能力的企业。
通过利用先进的半导体中道技术(W2W Bonding,TSV, RDL, Bumping等),实现在3D表面的重布线,其实现的FAN-IN结构很好的解决了传感器芯片封装正面开窗,并且尺寸小,低功耗和高密度集成化的要求。利用该技术的不同版本,可以针对例如CIS, MEMS,ALS和LED等不同种类芯片的小型化封装。
晶圆级WLO技术利用了半导体设备的精度和加工效率,在微镜头,微阵列,衍射器件等方面都由应用,有效的缩小了光学系统的尺寸,使得光学器件产品设计可以无缝融入集成电路产品的封装中,大大降低了模块的尺寸和成本,在3D深度和AR/VR领域有广泛的用途。
在原有晶圆级技术基础上,公司开发了针对大尺寸,多芯片封装的F/O结构封装,将原来的FAN-IN RDL层重置到一块玻璃或者有机基板上,并通过倒装工艺,W/B工艺完成系统集成。该封装的特点是可以实现高像素芯片,或者多芯片,或者高可靠性车用芯片的封装,为系统化集成提供了一个灵活的平台。
目前公司依托核心的晶圆级TSV封装工艺,正在与客户合作开发拓展三维堆叠技术,形成完备的“CIS芯片+DRAM芯片+ISP芯片”三维堆叠设计与制造能力,以此为基础并购整合人工智能应用的软件和算法,形成完整的“软件+硬件”有机协同的系统集成服务能力。
通富微电在2018年持续加大Bumping+FC为主的高端封测技术研发,包括:1、与AMD配套的7nm封测,已顺利进入量产阶段;2、多芯片倒装技术;3、扇出型封装、2.5D和3D封装、SiP系统级封装等。
一、全新产品和全新技术的开发与应用成为公司技术亮点,将培育成为公司新的增长点,为经营业绩的可持续发展奠定了基础。
Gold bump顺利导入和量产:完成先进封装生产线%)。三季度顺利通过多家客户审核验证,四季度量产即产出两千片,是中国显示驱动芯片行业做强的坚实一步;
2018年Driver IC CP完成产线建设并通过国际大客户验证:完成业界领先的8寸和12寸产品测试能力建设,全球五大Driver IC厂商中已有两家验证通过;
COF封装产线试产成功:最严苛产品规格(芯片高长宽比等)试产成功,进入高端显示驱动芯片封装领域。
NB-IoT面向物联网行业领先SiP解决方案,2018年开发完成并成功招标进入中国电信等运营商模组解决方案。
Large Size Saw Type Dual Row QFN:业界主流高性能能低成本技术,业界首批完成自动化产线建立并具备大规模量产能力的封测企业。
(Wettbale Flank)进入考核:完成样品进入考核制作,成为首家掌握此车载封装技术的企业,夯实国产车载汽车芯片发展的根基。
TOLL/LFPAK:持续启动Power前沿产品,进一步稳固了通富业界Power封测领先地位。
Exposed Die (露芯片) CUF和MUF解决方案:3个月内建立能力并快速建成最大规模能力,并零质量事故。
5G射频和触控用薄FBGA:全球首批提供5G大功率射频产品的封测企业,以及首批高端旗舰手机触控FBGA产品。3
3月,江苏中科智芯集成科技有限公司成立,承接华进半导体晶圆级扇出型封装产业化项目。据悉,主厂房于2018年11月底封顶;其他辅助建筑于2019年1月封顶。净化装修工作业已开始,计划2019年5月全部完工,净化间开始试运行。建成后陆续投产12英寸晶圆级扇出型封装,逐步实现单芯片扇出型封装、2D多芯片扇出型封装、3D多芯片扇出型封装量产。
华进半导体表示,中科智芯产品定位中高密度集成芯片扇出型(Fan-Out)封装与测试,高频率射频芯片封装的设计与制造。
晶圆级扇出型封装是最高性价比的集成电路封装技术,无须使用印刷电路板,可直接在晶圆上实现芯片封装。具体来说,第一,结合内嵌式印刷电路板技术的系统级封装,虽符合移动设备小型化需求,然而供应链、产品良率(成本)存在很多问题;第二,硅穿孔(TSV )封装技术可以实现产品良率的问题,但设计难度较大、制造成本极高。与上述两种方案不同的晶圆级扇出封装(Fan-Out)技术,可在单芯至多芯片的封装中做到更高的集成度,而具有更好的
属性,不仅降低封装成本,并且让系统计算速度加快,产生的功耗更小,更为重要的是,该技术能够提供更好的散热性能,并可以整合射频元件,使网络基带性能更加优良。
FBGA、PBGA、SiP模组、P-SiP模组、通讯模块-LGA、高脚位通讯模块、倒装通讯模块等通信用高密度集成电路及模块封装产品年产20亿块的生产能力。项目建设期3年。
Bumping、WLCSP等通讯与物联网集成电路中道封装年产82万片Bumping、47亿颗芯片封装的生产能力。项目建设期3年。
5月23日,长电科技集成电路封测基地项目正式开工。宿迁厂以脚数较低的IC和功率器件为主,低成本是其竞争优势。
8月21日,厦门通富微电子有限公司一期工程奠基。目一期投资13.8亿元,一期用地约100亩,规划建设2万片Bumping、CP以及2万片WLCSP、SiP中试线日,通富微电发布公告,称计划与厦门半导体投资集团有限公司共同出资在厦门市海沧区投资项目公司,成立厦门通富微电子有限公司,注册资本为7亿元人民币。从公告内容知道,通富微电虽然仅出资7000万元人民币,在合资公司中占股为
,但在3个董事会席位中占有2席。2017年6月26日,厦门市海沧区人民政府与通富微电签署了共建集成电路先进封测生产线的战略合作协议。按协议约定,项目总投资70亿元,规划建设以Bumping、
、CP、FC、SiP及三、五族化合物为主的先进封装测试产业化基地,重点服务于“福、厦、漳、泉”及华南地区的区域市场和重点企业,项目分三期实施。7、南通通富二期工程2017年
经过2018年全年的建设,2019年1月30日上午,南通通富微电子有限公司二期工程成功封顶。
月16日,在“国家集成电路重大专项走进安徽活动”中,通富微电表示,将在合肥设驱动芯片封装和存储封测项目。
驱动芯片封装项目将建成一条世界先进的包含10多种12英寸国产装备的液晶驱动芯片封装测试生产线。该项目的研发整整已经在通富总部完成,将很快在合肥通富进行量产线建设。通富微电的存储封测已经具备4层堆叠量产能力,正在和合肥睿力合作开展应用于高端
月7日,华天科技发布公告,董事会同意投资南京集成电路先进封测产业基地项目,并与南京浦口经济开发区管理委员会签订南京集成电路先进封测产业基地项目《投资协议》。项目分三期建设完成,全部项目计划不晚于2028年12月
日建成运营。项目投资总额80亿元。最新消息:2019年1月24日上午,华天科技(南京)有限公司集成电路先进封测产业基地项目开工仪式在浦口区举行。
月7日,华天科技控股子公司华天科技(昆山)电子有限公司高可靠性车用晶圆级先进封装生产线项目签约仪式在昆山开发区成功举行,至此华天科技在昆山布局了三条技术领先的高端封测量产产线开工建设
月3日动工至今,一切进展顺利。K25厂总投资金额达新台币125亿元,预计2020年完工。日月光表示,K25厂房是日月光推动的
年6厂投资计划之一,将专攻高端的3C、通信、车用、消费性电子、以及绘图芯片等应用领域。目前楠梓加工区第二园区K21厂、K22厂、K23厂已完工进驻;K24厂已经投产,到
12、日月光新加坡厂扩产WLCSP产能2018年,日月光新加坡厂WLCSP的月产能达1亿颗规模,较2017年7000万颗的产能扩产幅度达5成,强化日月光在通讯芯片WLCSP封测领域的竞争力。日月光新加坡厂前身是ISELabs Singapore,成立于1998年,日月光在1999年并购该厂后,2003年正式更名为日月光新加坡厂PG电子游戏官方网站。而日月光2010年收购EEMS Singapore公司后,再强化半导体测试业务。并于2014年建设了WLCSP封装产能。
马来西亚基地是日月光第一个在海外设立的封测厂,目前是汽车电子芯片封测重镇,营收占比达20~25%,同时也是电动车与专用大电流铜制弹片(copper clips)制程主要据点。
2018年4月,矽品电子(福建)有限公司晋江新厂动工。投资金额2500万美元,主攻存储器和逻辑产品封装与测试。
竹科三厂将成为全球首座面板级扇出型封装制程的量产基地,预期月产能将可达约5万片,约与15万片12英寸晶圆相当。力成表示,面板级扇出型封装可降低封装厚度、增加导线密度、提升产品电性,面板大工作平台可提高生产效率,可运用于5G、AI、自动驾驶、生物技术及物联网等相关产品。
2018年京元电子资本支出达新台币75亿元,以满足铜锣、苏州扩建新厂及采购测试设备。2018年
京元电子表示,此次兴建铜锣三厂,主要为满足各大客户在人工智能、物联网、微机电、移动通讯、电竞和车用电子产品测试业务需求持续增加,以及因应IDM厂测试委外加速趋势。
万坪。由于铜锣厂区的生产设备配置,主要以自行开发的测试设备为主,未来新厂依不同测试平台需求,预期可增设800至1000台测试设备。子公司京隆科技(苏州)有限公司在苏州运营A厂,始建于2002年,目前产能满载。公司于2018年开始扩充产产能,在原先建好的B厂房中安装设备调试,预计2019年3月投产。另外,2019年苏州震坤科技有限公司将并入京隆科技(苏州)有限公司,实现苏州厂封装测试一体化运营。
这是安靠在中国***的第4座先进封测厂,落脚于龙潭园区。T6厂也是安靠在***建设的唯一新厂,原有3个厂房都是收购而来。
安靠于2001年在***合并上宝半导体与台宏半导体,成立安靠***分公司,2004年并购众晶科技湖口厂,同年入主悠立半导体,2010年进驻竹科龙潭。 为因应订单需求增加,安靠于2017年4月收购原诺发光电厂房,将2层厂房改造为现代化的3层高新封测厂,并引进晶圆测试(Wafer Probe)及裸晶切割封装(DPS)设备,结合既有龙潭T1厂产能,提供客户晶圆级封装(WLSCP)、先进测试,bump-probe-DPS一条龙服务。
2018年5月,SFA韩国天安二厂K2投产。在OSAT扩大产能的同时,晶圆代工公司台积电也在扩大其先进封装产能。
台积电除在龙潭扩产先进封装,也在中科10纳米重镇FAB15厂区旁的原台积太阳能厂增加InFO新厂,整体产能可望倍增。
2018年9月,台积电在竹南实施先进封测厂建厂计划,已开始进行建厂环评作业,预估半年内完成相关程序,并预计在2020年完成设厂。
2018年9月12日,华天科技发布公告称,公司拟与控股股东天水华天电子集团、马来西亚主板上市公司Unisem股东
Tet等联合要约人,收购除马来西亚联合要约人直接持有Unisem公司股份以外的股份,约占Unisem公司流通股总额的75.72%。
2018年11月16日,要约已在国家发改委完成境外投资备案,取得商务部门颁发的《企业境外投资证书》并完成相关外汇登记。最新消息:2019年1月11日,华天科技与控股股东天水华天电子集团要约的股份占Unisem公司流通股总额的
,联合要约人已持有的股份占流通股总额的24.28%。联合要约人已持有和有效接受要约股份数合计占Unisem公司流通股总额的83.22%。此次要约股份交割工作正在进行中,预计交易对价约合人民币23.32亿元。
矽品科技(苏州)有限公司是矽品精密工业股份有限公司(SPIL)2001年在苏州设立的独资子公司。2017年11月紫光宣布经10.26亿元收购矽品科技(苏州)有限公司30%股权。此收购案发生在2017年11月24日中国商务部有条件通过日月光与矽品精密的合并案之后的新动作。4、奕斯伟完成收购颀中科技68.15%股权2018年2月
日,合肥奕斯伟封测技术有限公司完成收购颀中科技(苏州)有限公司,颀中科技(苏州)有限公司是颀邦科技股份有限公司(Chipbond)2004年在苏州设立的独资子公司。2017年12月
日,颀邦科技宣布出售子公司颀中科技(苏州)有限公司部份股权予合肥地方政府基金、京东方旗下北京芯动能投资基金及北京奕斯伟科技。交易总金额约1.66亿美元
。2018年1月18日,合肥奕斯伟封测控股有限公司、颀中控股有限公司、合肥芯屏产业投资基金(有限合伙)、北京芯动能投资基金(有限合伙)、CTC INVESTMENT COMPANY LIMITED联合组建合肥奕斯伟封测技术有限公司。5、日月光收购恩智浦
在苏州日月新半导体有限公司所持股权。2018年3月,日月光宣布1.27亿美元收购了NXP(恩智浦)在苏州日月新半导体所持40%股权,以此持有苏州日月新半导体100%股权
30%股权。2018年8月,紫光宣布以29.18亿元新台币(约9534万美元)收购苏州日月新半导体有限公司30%股权。
此收购案发生在2017年11月24日中国商务部有条件通过日月光与矽品精密的合并案之后的第二个收购动作。之前是紫光收购矽品科技(苏州)有限公司30%的股权。7、京元电收购东琳精密
2018年11月1日,京元电完成对从事IC封装和记忆卡封装服务商东琳精密的合并(京元电持股约33.5%)2018年
月7日,京元电子(KYEC)董事会通过现金对价与东琳精密进行合并案,合并对价金额为4.56亿元。东琳精密从事IC封装和记忆卡封装服务,以竹南为营运据点,股东京元电
京元电子完成收购东琳精密后,将在***拥有第一座专业封装厂,之前其封装主要在苏州子公司--苏州震坤科技有限公司。8、苏州固锝完成收购AICS剩余股份2018年12月
日,苏州固锝经公司第六届董事会第七次会议审议通过,与AICS的股东AICC签署了《关于8%股权的转让协议》,本次收购完成后,公司持有AIC Semiconductor SDN BHD(AICS)100%的股权,AICS成为公司的全资子公司。
AICS被收购后目前主要提供SOIC、PDIP、QFN、SmartCard、气压传感器等产品封装测试业务。苏州固锝表示,整合标的公司拥有20多年经验的管理团队,以及马来西亚良好的半导体生产制造环境,在海外建立半导体封装测试生产基地,有利于苏州固锝提升国际影响力及行业地位。同时,标的公司的封装产品也增加了公司集成电路的封装品种,有利于苏州固锝获得先进封装技术,提升研发实力PG电子游戏官方网站,跻身全球一流封测企业。
Copyright © 2002-2023 PG电子·游戏(中国)官方网站 版权所有 HTML地图 XML地图 备案号:鲁ICP备2021039510号